QR కోడ్

ఉత్పత్తులు
మమ్మల్ని సంప్రదించండి


ఫ్యాక్స్
+86-579-87223657

ఇ-మెయిల్

చిరునామా
వాంగ్డా రోడ్, జియాంగ్ స్ట్రీట్, వుయి కౌంటీ, జిన్హువా సిటీ, జెజియాంగ్ ప్రావిన్స్, చైనా
సిలికాన్ కార్బైడ్ అధిక-ఉష్ణోగ్రత, అధిక-ఫ్రీక్వెన్సీ, అధిక-శక్తి మరియు అధిక-వోల్టేజ్ పరికరాలను తయారు చేయడానికి అనువైన పదార్థాలలో ఒకటి. ఉత్పత్తి సామర్థ్యాన్ని మెరుగుపరచడానికి మరియు ఖర్చులను తగ్గించడానికి, పెద్ద-పరిమాణ సిలికాన్ కార్బైడ్ ఉపరితలాల తయారీ ఒక ముఖ్యమైన అభివృద్ధి దిశ. యొక్క ప్రక్రియ అవసరాలను లక్ష్యంగా8-అంగుళాల సిలికాన్ కార్బైడ్ (SIC) సింగిల్ క్రిస్టల్ పెరుగుదల.TAC పూత రింగులు.Sic సింగిల్ క్రిస్టల్ గ్రోత్ ప్రాసెస్ విడి భాగాలువెటెక్ సెమీకండక్టర్ చేత అందించబడతాయి), సిలికాన్ కార్బైడ్ సింగిల్ క్రిస్టల్ గ్రోత్ కొలిమి యొక్క క్రూసిబుల్ రొటేషన్ మరియు ప్రాసెస్ పారామితి నియంత్రణ సాంకేతికత అధ్యయనం చేయబడ్డాయి మరియు 8-అంగుళాల స్ఫటికాలు విజయవంతంగా తయారు చేయబడ్డాయి మరియు థర్మల్ ఫీల్డ్ అనుకరణ విశ్లేషణ మరియు ప్రక్రియ ప్రయోగాల ద్వారా పెరిగాయి.
పరిచయం
సిలికాన్ కార్బైడ్ (SIC) మూడవ తరం సెమీకండక్టర్ పదార్థాల యొక్క సాధారణ ప్రతినిధి. ఇది పెద్ద బ్యాండ్గ్యాప్ వెడల్పు, అధిక బ్రేక్డౌన్ ఎలక్ట్రిక్ ఫీల్డ్ మరియు అధిక ఉష్ణ వాహకత వంటి పనితీరు ప్రయోజనాలను కలిగి ఉంది. ఇది అధిక ఉష్ణోగ్రత, అధిక పీడనం మరియు అధిక పౌన frequency పున్య క్షేత్రాలలో బాగా పనిచేస్తుంది మరియు సెమీకండక్టర్ మెటీరియల్ టెక్నాలజీ రంగంలో ప్రధాన అభివృద్ధి దిశలలో ఒకటిగా మారింది. ప్రస్తుతం, సిలికాన్ కార్బైడ్ స్ఫటికాల యొక్క పారిశ్రామిక పెరుగుదల ప్రధానంగా భౌతిక ఆవిరి రవాణా (పివిటి) ను ఉపయోగిస్తుంది, ఇందులో బహుళ-దశ, బహుళ-భాగాలు, బహుళ వేడి మరియు ద్రవ్యరాశి బదిలీ మరియు మాగ్నెటో-ఎలక్ట్రిక్ ఉష్ణ ప్రవాహ సంకర్షణ యొక్క సంక్లిష్ట బహుళ-భౌతిక క్షేత్ర కలపడం సమస్యలు ఉంటాయి. అందువల్ల, పివిటి వృద్ధి వ్యవస్థ యొక్క రూపకల్పన కష్టం, మరియు సమయంలో ప్రాసెస్ పారామితి కొలత మరియు నియంత్రణక్రిస్టల్ పెరుగుదల ప్రక్రియకష్టం, ఫలితంగా ఎదిగిన సిలికాన్ కార్బైడ్ స్ఫటికాలు మరియు చిన్న క్రిస్టల్ పరిమాణం యొక్క నాణ్యత లోపాలను నియంత్రించడంలో ఇబ్బంది వస్తుంది, తద్వారా సిలికాన్ కార్బైడ్ ఉన్న పరికరాల ఖర్చు ఉపరితలం ఎక్కువగా ఉంటుంది.
సిలికాన్ కార్బైడ్ తయారీ పరికరాలు సిలికాన్ కార్బైడ్ టెక్నాలజీ మరియు పారిశ్రామిక అభివృద్ధికి పునాది. సిలికాన్ కార్బైడ్ సింగిల్ క్రిస్టల్ గ్రోత్ కొలిమి యొక్క సాంకేతిక స్థాయి, ప్రాసెస్ సామర్ధ్యం మరియు స్వతంత్ర హామీ పెద్ద పరిమాణం మరియు అధిక దిగుబడి దిశలో సిలికాన్ కార్బైడ్ పదార్థాల అభివృద్ధికి కీలకం, మరియు తక్కువ ఖర్చు మరియు పెద్ద-స్థాయి దిశలో అభివృద్ధి చెందడానికి మూడవ తరం సెమీకండక్టర్ పరిశ్రమను నడిపించే ప్రధాన కారకాలు. సిలికాన్ కార్బైడ్ సింగిల్ క్రిస్టల్తో సెమీకండక్టర్ పరికరాల్లో, ఉపరితల విలువ అతిపెద్ద నిష్పత్తికి, సుమారు 50%. పెద్ద-పరిమాణ అధిక-నాణ్యత సిలికాన్ కార్బైడ్ క్రిస్టల్ వృద్ధి పరికరాల అభివృద్ధి, సిలికాన్ కార్బైడ్ సింగిల్ క్రిస్టల్ సబ్స్ట్రేట్ల దిగుబడి మరియు వృద్ధి రేటును మెరుగుపరచడం మరియు ఉత్పత్తి ఖర్చులను తగ్గించడం సంబంధిత పరికరాల అనువర్తనానికి కీలకమైన ప్రాముఖ్యత. ఉత్పత్తి సామర్థ్య సరఫరాను పెంచడానికి మరియు సిలికాన్ కార్బైడ్ పరికరాల సగటు వ్యయాన్ని మరింత తగ్గించడానికి, సిలికాన్ కార్బైడ్ ఉపరితలాల పరిమాణాన్ని విస్తరించడం ముఖ్యమైన మార్గాలలో ఒకటి. ప్రస్తుతం, అంతర్జాతీయ ప్రధాన స్రవంతి సిలికాన్ కార్బైడ్ సబ్స్ట్రేట్ పరిమాణం 6 అంగుళాలు, మరియు ఇది వేగంగా 8 అంగుళాలకు ముందుకు సాగుతోంది.
8-అంగుళాల సిలికాన్ కార్బైడ్ సింగిల్ క్రిస్టల్ గ్రోత్ ఫర్నేసుల అభివృద్ధిలో పరిష్కరించాల్సిన ప్రధాన సాంకేతికతలు: (1) చిన్న రేడియల్ ఉష్ణోగ్రత ప్రవణత మరియు 8-అంగుళాల సిలికాన్ కార్బైడ్ స్ఫటికాల పెరుగుదలకు తగిన పెద్ద రేఖాంశ ఉష్ణోగ్రత ప్రవణతను పొందటానికి పెద్ద-పరిమాణ ఉష్ణ క్షేత్ర నిర్మాణం యొక్క రూపకల్పన. . (3) అధిక-నాణ్యత సింగిల్ క్రిస్టల్ వృద్ధి ప్రక్రియ యొక్క అవసరాలను తీర్చగల డైనమిక్ పరిస్థితులలో ప్రాసెస్ పారామితుల స్వయంచాలక నియంత్రణ.
1 పివిటి క్రిస్టల్ గ్రోత్ మెకానిజం
పివిటి పద్ధతి సిలికాన్ కార్బైడ్ సింగిల్ స్ఫటికాలను తయారు చేయడం, సిక్ మూలాన్ని స్థూపాకార దట్టమైన గ్రాఫైట్ క్రూసిబుల్ దిగువన ఉంచడం ద్వారా, మరియు సిక్ సీడ్ క్రిస్టల్ క్రూసిబుల్ కవర్ దగ్గర ఉంచబడుతుంది. రేడియో ఫ్రీక్వెన్సీ ఇండక్షన్ లేదా రెసిస్టెన్స్ ద్వారా క్రూసిబుల్ 2 300 ~ 2 400 to కు వేడి చేయబడుతుంది మరియు గ్రాఫైట్ అనుభూతి ద్వారా ఇన్సులేట్ చేయబడింది లేదాపోరస్ గ్రాఫైట్. SIC మూలం నుండి సీడ్ క్రిస్టల్కు రవాణా చేయబడిన ప్రధాన పదార్థాలు Si, Si2C అణువులు మరియు SIC2. విత్తన క్రిస్టల్ వద్ద ఉష్ణోగ్రత తక్కువ మైక్రో-పౌడర్ వద్ద కంటే కొంచెం తక్కువగా ఉంటుంది మరియు క్రూసిబుల్లో అక్షసంబంధ ఉష్ణోగ్రత ప్రవణత ఏర్పడుతుంది. మూర్తి 1 లో చూపినట్లుగా, సిలికాన్ కార్బైడ్ మైక్రో-పౌడర్ వివిధ గ్యాస్ దశ భాగాల యొక్క ప్రతిచర్య వాయువులను ఏర్పరుస్తుంది, ఇవి ఉష్ణోగ్రత ప్రవణత యొక్క డ్రైవ్ కింద విత్తన క్రిస్టల్కు తక్కువ ఉష్ణోగ్రతతో చేరుతాయి మరియు దానిపై స్ఫటికీకరిస్తాయి మరియు స్థూపాకార సిలికాన్ కార్బైడ్ ఇంగోట్ను ఏర్పరుస్తాయి.
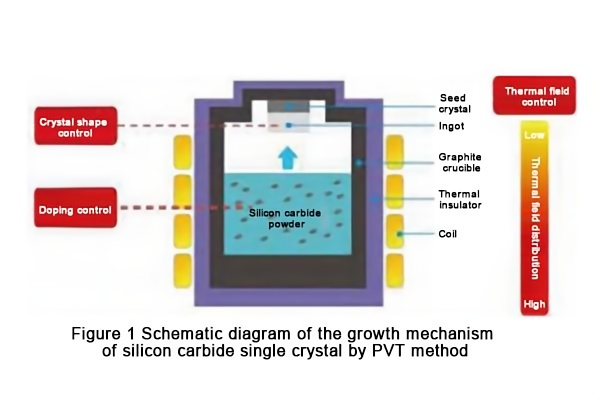
పివిటి పెరుగుదల యొక్క ప్రధాన రసాయన ప్రతిచర్యలు:
Sic (s) ⇌ si (g)+c (లు)
2SIC ⇌ మరియు2సి (జి)+సి (లు)
2sic ⇌ sic2 (g)+si (l, g)
Sic (లు) ⇌ sic (g)
SIC సింగిల్ స్ఫటికాల PVT పెరుగుదల యొక్క లక్షణాలు:
1) రెండు గ్యాస్-సోలిడ్ ఇంటర్ఫేస్లు ఉన్నాయి: ఒకటి గ్యాస్-సిక్ పౌడర్ ఇంటర్ఫేస్, మరియు మరొకటి గ్యాస్-క్రిస్టల్ ఇంటర్ఫేస్.
2) గ్యాస్ దశ రెండు రకాల పదార్థాలతో కూడి ఉంటుంది: ఒకటి వ్యవస్థలో ప్రవేశపెట్టిన జడ అణువులు; మరొకటి గ్యాస్ ఫేజ్ కాంపోనెంట్ SIMCN, యొక్క కుళ్ళిపోవడం మరియు సబ్లిమేషన్ ద్వారా ఉత్పత్తి అవుతుందిSic పౌడర్. గ్యాస్ దశ భాగాలు సిమ్క్న్ ఒకదానితో ఒకటి సంకర్షణ చెందుతాయి మరియు స్ఫటికీకరణ ప్రక్రియ యొక్క అవసరాలను తీర్చగల స్ఫటికాకార గ్యాస్ ఫేజ్ భాగాలు సిఎమ్సిఎన్ అని పిలవబడే భాగం SIC క్రిస్టల్గా పెరుగుతుంది.
3) ఘన సిలికాన్ కార్బైడ్ పౌడర్లో, సబ్లిమేట్ చేయని కణాల మధ్య ఘన-దశ ప్రతిచర్యలు సంభవిస్తాయి, కొన్ని కణాలు సింటరింగ్ ద్వారా పోరస్ సిరామిక్ శరీరాలను ఏర్పరుస్తాయి, కొన్ని కణాలు ఒక నిర్దిష్ట కణ పరిమాణం మరియు స్ఫటికీకరణ కణాల ద్వారా కొన్ని సిలికాన్ కార్బైడ్ కణాలు లేదా కార్బైడ్ కణాలుగా మారుతున్న కొన్ని కణాలు ధాన్యాలను ఏర్పరుస్తాయి. సబ్లిమేషన్.
4) క్రిస్టల్ వృద్ధి ప్రక్రియలో, రెండు దశల మార్పులు సంభవిస్తాయి: ఒకటి, ఘన సిలికాన్ కార్బైడ్ పౌడర్ కణాలు గ్యాస్ ఫేజ్ భాగాలుగా మార్చబడతాయి, నాన్-స్టోయికియోమెట్రిక్ కుళ్ళిపోవడం మరియు సబ్లిమేషన్ ద్వారా సిమ్క్న్, మరియు మరొకటి గ్యాస్ ఫేజ్ భాగాలు సింప్న్ స్ఫటికీకరణ ద్వారా లాటిస్ కణాలుగా మారుతాయి.
2 పరికరాల రూపకల్పన
మూర్తి 2 లో చూపినట్లుగా, సిలికాన్ కార్బైడ్ సింగిల్ క్రిస్టల్ గ్రోత్ కొలిమి ప్రధానంగా ఉన్నాయి: ఎగువ కవర్ అసెంబ్లీ, ఛాంబర్ అసెంబ్లీ, తాపన వ్యవస్థ, క్రూసిబుల్ రొటేషన్ మెకానిజం, తక్కువ కవర్ లిఫ్టింగ్ మెకానిజం మరియు ఎలక్ట్రికల్ కంట్రోల్ సిస్టమ్.

2.1 తాపన వ్యవస్థ
మూర్తి 3 లో చూపినట్లుగా, తాపన వ్యవస్థ ఇండక్షన్ తాపనాన్ని అవలంబిస్తుంది మరియు ఇండక్షన్ కాయిల్, aగ్రాఫైట్ క్రూసిబుల్, ఇన్సులేషన్ పొర (దృ g మైన అనుభూతి, మృదువైన అనుభూతి). అధిక-స్వచ్ఛత గ్రాఫైట్ క్రూసిబుల్ పదార్థం మంచి వాహకతను కలిగి ఉన్నందున, క్రూసిబుల్ గోడపై ప్రేరేపిత ప్రవాహం ఉత్పత్తి అవుతుంది, ఇది ఎడ్డీ కరెంట్ను ఏర్పరుస్తుంది. లోరెంజ్ ఫోర్స్ యొక్క చర్యలో, ప్రేరిత ప్రవాహం చివరికి క్రూసిబుల్ యొక్క బయటి గోడపై కలుస్తుంది (అనగా, చర్మ ప్రభావం) మరియు రేడియల్ దిశలో క్రమంగా బలహీనపడుతుంది. ఎడ్డీ ప్రవాహాల ఉనికి కారణంగా, జూల్ హీట్ క్రూసిబుల్ యొక్క బయటి గోడపై ఉత్పత్తి అవుతుంది, ఇది వృద్ధి వ్యవస్థ యొక్క తాపన వనరుగా మారుతుంది. జూల్ వేడి యొక్క పరిమాణం మరియు పంపిణీ క్రూసిబుల్లోని ఉష్ణోగ్రత క్షేత్రాన్ని నేరుగా నిర్ణయిస్తాయి, ఇది క్రిస్టల్ యొక్క పెరుగుదలను ప్రభావితం చేస్తుంది.
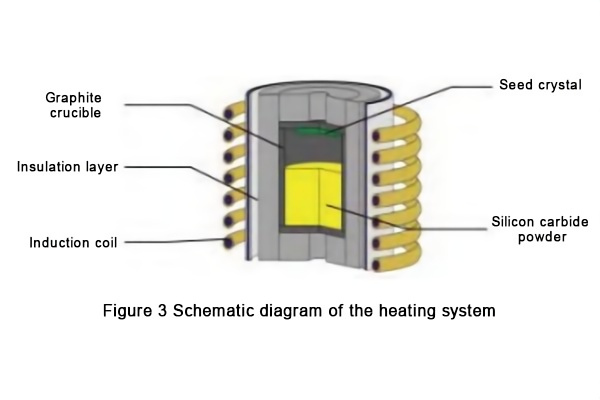
మూర్తి 4 లో చూపినట్లుగా, ఇండక్షన్ కాయిల్ తాపన వ్యవస్థలో కీలకమైన భాగం. ఇది స్వతంత్ర కాయిల్ నిర్మాణాల యొక్క రెండు సెట్లని అవలంబిస్తుంది మరియు వరుసగా ఎగువ మరియు దిగువ ఖచ్చితమైన చలన విధానాలను కలిగి ఉంటుంది. మొత్తం తాపన వ్యవస్థ యొక్క విద్యుత్ ఉష్ణ నష్టం చాలా కాయిల్ చేత భరిస్తారు మరియు బలవంతంగా శీతలీకరణ చేయాలి. కాయిల్ రాగి గొట్టంతో గాయపడి, లోపల నీటితో చల్లబడుతుంది. ప్రేరిత ప్రవాహం యొక్క ఫ్రీక్వెన్సీ పరిధి 8 ~ 12 kHz. ఇండక్షన్ తాపన యొక్క పౌన frequency పున్యం గ్రాఫైట్ క్రూసిబుల్లోని విద్యుదయస్కాంత క్షేత్రం యొక్క చొచ్చుకుపోయే లోతును నిర్ణయిస్తుంది. కాయిల్ మోషన్ మెకానిజం మోటారు-నడిచే స్క్రూ జత విధానాన్ని ఉపయోగిస్తుంది. పౌడర్ యొక్క సబ్లిమేషన్ సాధించడానికి అంతర్గత గ్రాఫైట్ క్రూసిబుల్ను వేడి చేయడానికి ఇండక్షన్ కాయిల్ ఇండక్షన్ విద్యుత్ సరఫరాతో సహకరిస్తుంది. అదే సమయంలో, రెండు సెట్ల కాయిల్స్ యొక్క శక్తి మరియు సాపేక్ష స్థానం విత్తన క్రిస్టల్ వద్ద ఉష్ణోగ్రత తక్కువ మైక్రో-పౌడర్ వద్ద కంటే తక్కువగా ఉండటానికి నియంత్రించబడుతుంది, విత్తన క్రిస్టల్ మరియు క్రూసిబుల్లోని పొడి మధ్య అక్షసంబంధ ఉష్ణోగ్రత ప్రవణతను ఏర్పరుస్తుంది మరియు సిలికాన్ కార్బైడ్ క్రిస్టల్ వద్ద సహేతుకమైన రేడియల్ ఉష్ణోగ్రత ప్రవణతను ఏర్పరుస్తుంది.

2.2 క్రూసిబుల్ భ్రమణ విధానం
పెద్ద-పరిమాణ పెరుగుదల సమయంలోసిలికాన్ కార్బైడ్ సింగిల్ స్ఫటికాలు. మూర్తి 5 లో చూపినట్లుగా, క్రూసిబుల్ యొక్క స్థిరమైన భ్రమణాన్ని సాధించడానికి మోటారు-ఆధారిత గేర్ జత ఉపయోగించబడుతుంది. తిరిగే షాఫ్ట్ యొక్క డైనమిక్ సీలింగ్ సాధించడానికి అయస్కాంత ద్రవ సీలింగ్ నిర్మాణం ఉపయోగించబడుతుంది. మాగ్నెటిక్ ఫ్లూయిడ్ సీల్ అయస్కాంతం, మాగ్నెటిక్ పోల్ షూ మరియు మాగ్నెటిక్ స్లీవ్ మధ్య ఏర్పడిన తిరిగే మాగ్నెటిక్ ఫీల్డ్ సర్క్యూట్ను ఉపయోగిస్తుంది, ధ్రువ షూ చిట్కా మరియు స్లీవ్ మధ్య అయస్కాంత ద్రవాన్ని గట్టిగా శోషించడానికి ఓ-రింగ్ లాంటి ద్రవ ఉంగరాన్ని ఏర్పరుస్తుంది, సీలింగ్ యొక్క ఉద్దేశ్యాన్ని సాధించడానికి అంతరాన్ని పూర్తిగా అడ్డుకుంటుంది. భ్రమణ కదలిక వాతావరణం నుండి వాక్యూమ్ చాంబర్కు ప్రసారం చేయబడినప్పుడు, ద్రవ ఓ-రింగ్ డైనమిక్ సీలింగ్ పరికరం ఘన సీలింగ్లో సులభంగా దుస్తులు మరియు తక్కువ జీవితం యొక్క ప్రతికూలతలను అధిగమించడానికి ఉపయోగించబడుతుంది మరియు ద్రవ అయస్కాంత ద్రవం మొత్తం సీలు చేసిన స్థలాన్ని నింపగలదు, తద్వారా రెండు ఛానెల్లను నిరోధించగలదు మరియు రెండు ప్రాసెస్ సాధించగలదు. అయస్కాంత ద్రవం మరియు క్రూసిబుల్ మద్దతు అయస్కాంత ద్రవం మరియు క్రూసిబుల్ మద్దతు అయస్కాంత ద్రవం మరియు క్రూసిబుల్ మద్దతు యొక్క అధిక-ఉష్ణోగ్రత అనువర్తనాన్ని నిర్ధారించడానికి మరియు థర్మల్ ఫీల్డ్ స్టేట్ యొక్క స్థిరత్వాన్ని సాధించడానికి నీటి-శీతల నిర్మాణాన్ని అవలంబిస్తాయి.

2.3 తక్కువ కవర్ లిఫ్టింగ్ విధానం
దిగువ కవర్ లిఫ్టింగ్ మెకానిజం డ్రైవ్ మోటారు, బాల్ స్క్రూ, లీనియర్ గైడ్, లిఫ్టింగ్ బ్రాకెట్, కొలిమి కవర్ మరియు కొలిమి కవర్ బ్రాకెట్ కలిగి ఉంటుంది. మోటారు దిగువ కవర్ యొక్క పైకి క్రిందికి కదలికను గ్రహించడానికి రిడ్యూసర్ ద్వారా స్క్రూ గైడ్ జతకి అనుసంధానించబడిన కొలిమి కవర్ బ్రాకెట్ను నడుపుతుంది.
దిగువ కవర్ లిఫ్టింగ్ విధానం పెద్ద-పరిమాణ క్రూసిబుల్స్ యొక్క ప్లేస్మెంట్ మరియు తొలగింపును సులభతరం చేస్తుంది మరియు మరింత ముఖ్యంగా, దిగువ కొలిమి కవర్ యొక్క సీలింగ్ విశ్వసనీయతను నిర్ధారిస్తుంది. మొత్తం ప్రక్రియలో, గదిలో వాక్యూమ్, అధిక పీడనం మరియు అల్ప పీడనం వంటి ఒత్తిడి మార్పు దశలు ఉన్నాయి. దిగువ కవర్ యొక్క కుదింపు మరియు సీలింగ్ స్థితి నేరుగా ప్రక్రియ విశ్వసనీయతను ప్రభావితం చేస్తుంది. అధిక ఉష్ణోగ్రత కింద ముద్ర విఫలమైన తర్వాత, మొత్తం ప్రక్రియ రద్దు చేయబడుతుంది. మోటారు సర్వో కంట్రోల్ మరియు పరిమితి పరికరం ద్వారా, దిగువ కవర్ అసెంబ్లీ మరియు గది యొక్క బిగుతు మూర్తి 6 లో చూపిన విధంగా, ప్రాసెస్ పీడనం యొక్క స్థిరత్వాన్ని నిర్ధారించడానికి కొలిమి ఛాంబర్ సీలింగ్ రింగ్ యొక్క ఉత్తమ స్థితిని మరియు సీలింగ్ యొక్క ఉత్తమ స్థితిని సాధించడానికి నియంత్రించబడుతుంది.
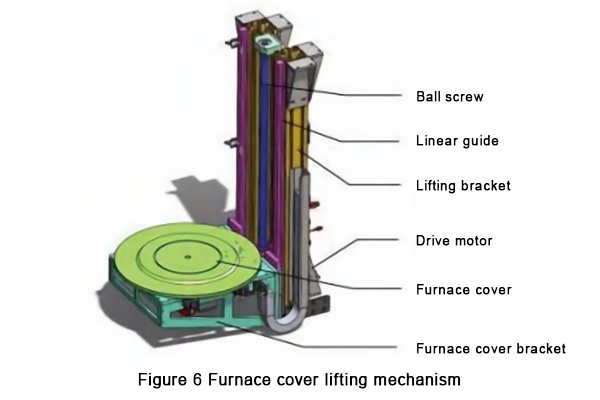
2.4 ఎలక్ట్రికల్ కంట్రోల్ సిస్టమ్
సిలికాన్ కార్బైడ్ స్ఫటికాల పెరుగుదల సమయంలో, ఎలక్ట్రికల్ కంట్రోల్ సిస్టమ్ వేర్వేరు ప్రాసెస్ పారామితులను ఖచ్చితంగా నియంత్రించాల్సిన అవసరం ఉంది, ప్రధానంగా కాయిల్ స్థానం ఎత్తు, క్రూసిబుల్ భ్రమణ రేటు, తాపన శక్తి మరియు ఉష్ణోగ్రత, వేర్వేరు ప్రత్యేక గ్యాస్ తీసుకోవడం ప్రవాహం మరియు అనుపాత వాల్వ్ తెరవడం.
మూర్తి 7 లో చూపినట్లుగా, నియంత్రణ వ్యవస్థ ప్రోగ్రామబుల్ కంట్రోలర్ను సర్వర్గా ఉపయోగిస్తుంది, ఇది కాయిల్ మరియు క్రూసిబుల్ యొక్క చలన నియంత్రణను గ్రహించడానికి బస్సు ద్వారా సర్వో డ్రైవర్కు అనుసంధానించబడి ఉంటుంది; ఉష్ణోగ్రత, పీడనం మరియు ప్రత్యేక ప్రక్రియ గ్యాస్ ప్రవాహం యొక్క నిజ-సమయ నియంత్రణను గ్రహించడానికి ఇది ప్రామాణిక మొబస్ఆర్టు ద్వారా ఉష్ణోగ్రత నియంత్రిక మరియు ఫ్లో కంట్రోలర్కు అనుసంధానించబడి ఉంటుంది. ఇది ఈథర్నెట్ ద్వారా కాన్ఫిగరేషన్ సాఫ్ట్వేర్తో కమ్యూనికేషన్ను ఏర్పాటు చేస్తుంది, సిస్టమ్ సమాచారాన్ని నిజ సమయంలో మార్పిడి చేస్తుంది మరియు హోస్ట్ కంప్యూటర్లో వివిధ ప్రాసెస్ పారామితి సమాచారాన్ని ప్రదర్శిస్తుంది. ఆపరేటర్లు, ప్రాసెస్ సిబ్బంది మరియు నిర్వాహకులు మానవ-యంత్ర ఇంటర్ఫేస్ ద్వారా నియంత్రణ వ్యవస్థతో సమాచారాన్ని మార్పిడి చేస్తారు.

నియంత్రణ వ్యవస్థ అన్ని ఫీల్డ్ డేటా సేకరణ, అన్ని యాక్యుయేటర్ల ఆపరేటింగ్ స్థితి యొక్క విశ్లేషణ మరియు యంత్రాంగాల మధ్య తార్కిక సంబంధాన్ని నిర్వహిస్తుంది. ప్రోగ్రామబుల్ కంట్రోలర్ హోస్ట్ కంప్యూటర్ యొక్క సూచనలను స్వీకరిస్తుంది మరియు సిస్టమ్ యొక్క ప్రతి యాక్యుయేటర్ యొక్క నియంత్రణను పూర్తి చేస్తుంది. ఆటోమేటిక్ ప్రాసెస్ మెను యొక్క అమలు మరియు భద్రతా వ్యూహం అన్నీ ప్రోగ్రామబుల్ కంట్రోలర్ చేత అమలు చేయబడతాయి. ప్రోగ్రామబుల్ కంట్రోలర్ యొక్క స్థిరత్వం ప్రాసెస్ మెను ఆపరేషన్ యొక్క స్థిరత్వం మరియు భద్రతా విశ్వసనీయతను నిర్ధారిస్తుంది.
ఎగువ కాన్ఫిగరేషన్ ప్రోగ్రామబుల్ కంట్రోలర్తో డేటా మార్పిడిని నిజ సమయంలో నిర్వహిస్తుంది మరియు ఫీల్డ్ డేటాను ప్రదర్శిస్తుంది. ఇది తాపన నియంత్రణ, ప్రెజర్ కంట్రోల్, గ్యాస్ సర్క్యూట్ కంట్రోల్ మరియు మోటారు నియంత్రణ వంటి ఆపరేషన్ ఇంటర్ఫేస్లతో అమర్చబడి ఉంటుంది మరియు వివిధ పారామితుల సెట్టింగ్ విలువలను ఇంటర్ఫేస్లో సవరించవచ్చు. అలారం పారామితుల యొక్క రియల్ టైమ్ పర్యవేక్షణ, స్క్రీన్ అలారం ప్రదర్శనను అందించడం, అలారం సంభవించడం మరియు పునరుద్ధరణ యొక్క సమయం మరియు వివరణాత్మక డేటాను రికార్డ్ చేయడం. అన్ని ప్రాసెస్ డేటా, స్క్రీన్ ఆపరేషన్ కంటెంట్ మరియు ఆపరేషన్ సమయం యొక్క రియల్ టైమ్ రికార్డింగ్. ప్రోగ్రామబుల్ కంట్రోలర్ లోపల అంతర్లీన కోడ్ ద్వారా వివిధ ప్రాసెస్ పారామితుల యొక్క ఫ్యూజన్ నియంత్రణ గ్రహించబడుతుంది మరియు గరిష్టంగా 100 దశల ప్రక్రియను గ్రహించవచ్చు. ప్రతి దశలో ప్రాసెస్ ఆపరేషన్ సమయం, లక్ష్య శక్తి, లక్ష్య పీడనం, ఆర్గాన్ ప్రవాహం, నత్రజని ప్రవాహం, హైడ్రోజన్ ప్రవాహం, క్రూసిబుల్ స్థానం మరియు క్రూసిబుల్ రేటు వంటి డజను కంటే ఎక్కువ ప్రాసెస్ పారామితులు ఉన్నాయి.
3 థర్మల్ ఫీల్డ్ సిమ్యులేషన్ అనాలిసిస్
థర్మల్ ఫీల్డ్ సిమ్యులేషన్ అనాలిసిస్ మోడల్ స్థాపించబడింది. మూర్తి 8 అనేది క్రూసిబుల్ గ్రోత్ చాంబర్లో ఉష్ణోగ్రత క్లౌడ్ మ్యాప్. 4H-SIC సింగిల్ క్రిస్టల్ యొక్క పెరుగుదల ఉష్ణోగ్రత పరిధిని నిర్ధారించడానికి, విత్తన క్రిస్టల్ యొక్క మధ్య ఉష్ణోగ్రత 2200 ℃ గా లెక్కించబడుతుంది మరియు అంచు ఉష్ణోగ్రత 2205.4. At this time, the center temperature of the crucible top is 2167.5℃, and the highest temperature of the powder area (side down) is 2274.4℃, forming an axial temperature gradient.

క్రిస్టల్ యొక్క రేడియల్ ప్రవణత పంపిణీ మూర్తి 9 లో చూపబడింది. విత్తన క్రిస్టల్ ఉపరితలం యొక్క తక్కువ పార్శ్వ ఉష్ణోగ్రత ప్రవణత క్రిస్టల్ పెరుగుదల ఆకారాన్ని సమర్థవంతంగా మెరుగుపరుస్తుంది. ప్రస్తుత లెక్కించిన ప్రారంభ ఉష్ణోగ్రత వ్యత్యాసం 5.4 ℃, మరియు మొత్తం ఆకారం దాదాపు ఫ్లాట్ మరియు కొద్దిగా కుంభాకారంగా ఉంటుంది, ఇది విత్తన క్రిస్టల్ ఉపరితలం యొక్క రేడియల్ ఉష్ణోగ్రత నియంత్రణ ఖచ్చితత్వం మరియు ఏకరూప అవసరాలను తీర్చగలదు.

ముడి పదార్థ ఉపరితలం మరియు విత్తన క్రిస్టల్ ఉపరితలం మధ్య ఉష్ణోగ్రత వ్యత్యాస వక్రత మూర్తి 10 లో చూపబడింది. పదార్థ ఉపరితలం యొక్క మధ్య ఉష్ణోగ్రత 2210 ℃, మరియు 1 ℃/సెం.మీ.
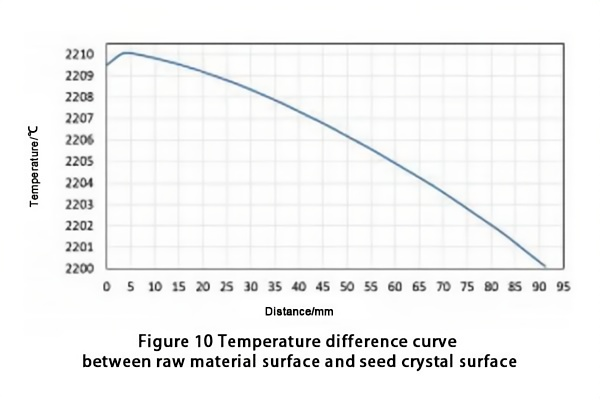
అంచనా వృద్ధి రేటు మూర్తి 11 లో చూపబడింది. చాలా వేగంగా వృద్ధి రేటు పాలిమార్ఫిజం మరియు తొలగుట వంటి లోపాల సంభావ్యతను పెంచుతుంది. ప్రస్తుత అంచనా వృద్ధి రేటు H.1 mm/h కి దగ్గరగా ఉంటుంది, ఇది సహేతుకమైన పరిధిలో ఉంది.

థర్మల్ ఫీల్డ్ సిమ్యులేషన్ అనాలిసిస్ మరియు లెక్కింపు ద్వారా, విత్తన క్రిస్టల్ యొక్క మధ్య ఉష్ణోగ్రత మరియు అంచు ఉష్ణోగ్రత 8 అంగుళాల క్రిస్టల్ యొక్క రేడియల్ ఉష్ణోగ్రత ప్రవణతను కలుస్తుంది. అదే సమయంలో, క్రూసిబుల్ యొక్క ఎగువ మరియు దిగువ క్రిస్టల్ యొక్క పొడవు మరియు మందానికి అనువైన అక్షసంబంధ ఉష్ణోగ్రత ప్రవణతను ఏర్పరుస్తాయి. వృద్ధి వ్యవస్థ యొక్క ప్రస్తుత తాపన పద్ధతి 8-అంగుళాల సింగిల్ స్ఫటికాల పెరుగుదలను కలిగిస్తుంది.
4 ప్రయోగాత్మక పరీక్ష
దీన్ని ఉపయోగించడంసిలికాన్ కార్బైడ్ సింగిల్ క్రిస్టల్ గ్రోత్ కొలిమి.

5 తీర్మానం
ప్రవణత థర్మల్ ఫీల్డ్, క్రూసిబుల్ మోషన్ మెకానిజం మరియు ప్రాసెస్ పారామితుల యొక్క ఆటోమేటిక్ కంట్రోల్ వంటి 8-అంగుళాల సిలికాన్ కార్బైడ్ సింగిల్ స్ఫటికాల పెరుగుదలకు ముఖ్య సాంకేతికతలు అధ్యయనం చేయబడ్డాయి. క్రూసిబుల్ గ్రోత్ ఛాంబర్లోని ఉష్ణ క్షేత్రం అనుకరణ మరియు ఆదర్శ ఉష్ణోగ్రత ప్రవణతను పొందటానికి విశ్లేషించబడింది. పరీక్ష తరువాత, డబుల్-కాయిల్ ఇండక్షన్ తాపన పద్ధతి పెద్ద-పరిమాణ పెరుగుదలను కలుస్తుందిసిలికాన్ కార్బైడ్ స్ఫటికాలు. ఈ సాంకేతిక పరిజ్ఞానం యొక్క పరిశోధన మరియు అభివృద్ధి 8-అంగుళాల కార్బైడ్ స్ఫటికాలను పొందటానికి పరికరాల సాంకేతికతను అందిస్తుంది మరియు సిలికాన్ కార్బైడ్ పారిశ్రామికీకరణను 6 అంగుళాల నుండి 8 అంగుళాల వరకు మార్చడానికి పరికరాల పునాదిని అందిస్తుంది, ఇది సిలికాన్ కార్బైడ్ పదార్థాల పెరుగుదల సామర్థ్యాన్ని మెరుగుపరుస్తుంది మరియు ఖర్చులను తగ్గిస్తుంది.



+86-579-87223657


వాంగ్డా రోడ్, జియాంగ్ స్ట్రీట్, వుయి కౌంటీ, జిన్హువా సిటీ, జెజియాంగ్ ప్రావిన్స్, చైనా
కాపీరైట్ © 2024 WuYi TianYao అడ్వాన్స్డ్ మెటీరియల్ Tech.Co.,Ltd. సర్వ హక్కులు ప్రత్యేకించబడినవి.
Links | Sitemap | RSS | XML | గోప్యతా విధానం |
